В этом году компания Samsung планирует представить обновленную технологию 3D-упаковки микросхем, которая позволит размещать память HBM поверх кристаллов CPU или GPU. В ближайшем будущем, вероятно в 2025-2026 годах, это позволит тесно интегрировать память HBM4 и процессоры между собой.
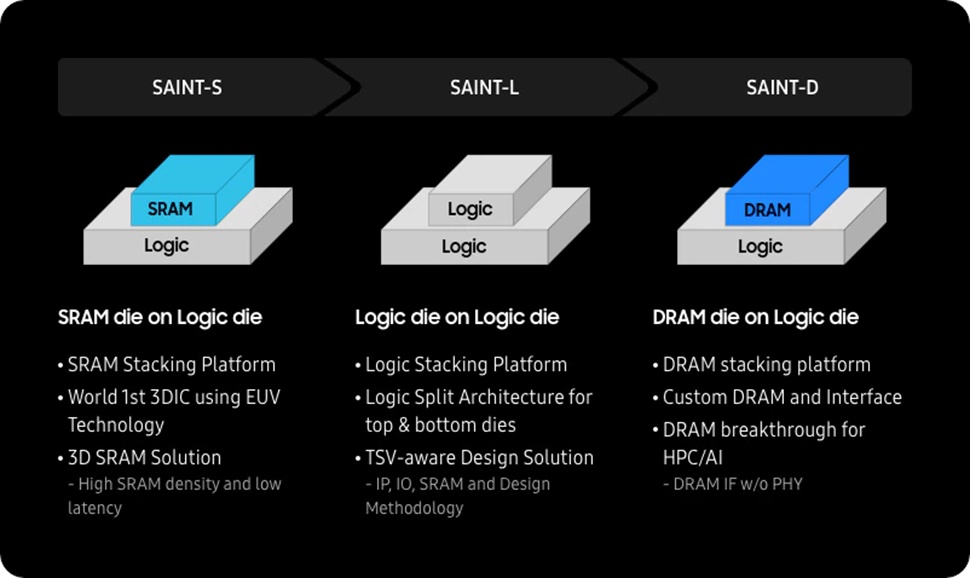
Базовая платформа Samsung для трехмерной упаковки микросхем называется SAINT (Samsung Advanced Interconnect Technology). Она включает в себя три последовательные технологии: SAINT-S для SRAM, SAINT-L для чипов логики, и SAINT-D для DRAM-памяти. Над последним типом соединения компания работает уже несколько лет и сейчас близка к завершению разработки. Суть технологии заключается в том, что чипы HBM будут расположены вертикально над процессорами и соединены с ними. Это существенный шаг вперед, по сравнению с нынешней 2,5D-технологией, где HBM чипы и процессоры GPU соединены горизонтально, через кремниевую подложку.

Технология 3D-упаковки предоставляет ряд существенных преимуществ для HBM памяти, поскольку повышается скорость передачи данных, сигналы становятся чище, снижаются потребление энергии и задержки. Как всегда, единственным недостатком становится рост стоимости такого продукта. Единственное, что непонятно — какую именно память Samsung собирается сейчас устанавливать на микросхемы. Это требует специального дизайна чипов, а среди известных процессоров от крупных компаний нет ничего, что подпадает под такие требования и может быть выпущено до начала 2025 года.
Источник:
Tom`s Hardware




