Цього року компанія Samsung планує представити оновлену технологію 3D-пакування мікросхем, яка дозволить розташовувати пам'ять HBM поверх кристалів CPU або GPU. У найближчому майбутньому, ймовірно у 2025-2026 роках, це дасть змогу тісно інтегрувати пам'ять HBM4 та процесори між собою.
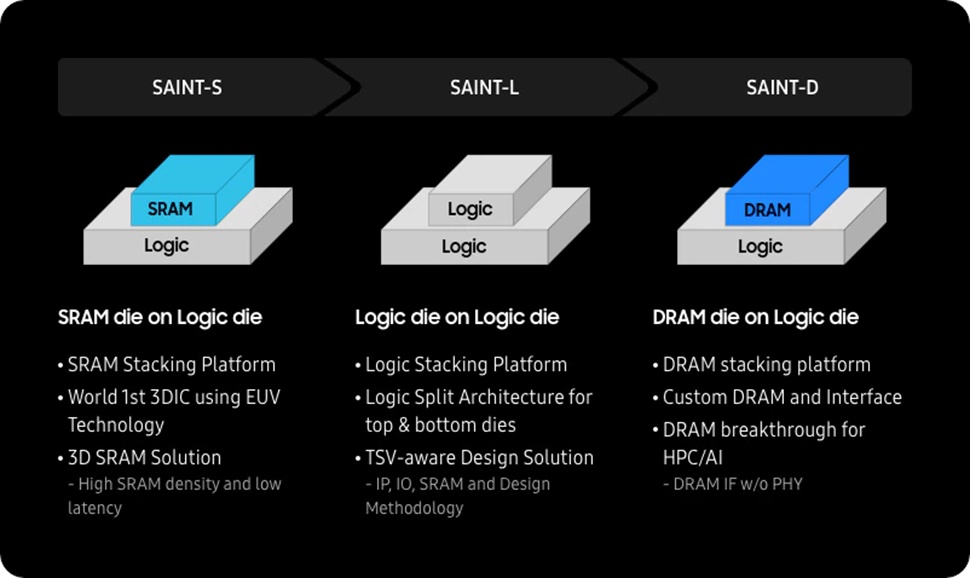
Базова платформа Samsung для тривимірного пакування мікросхем називається SAINT (Samsung Advanced Interconnect Technology). Вона має у собі три послідовні технології: SAINT-S для SRAM, SAINT-L для чипів логіки, та SAINT-D для DRAM-пам'яті. Над останнім типом з'єднання компанія працює вже декілька років та зараз близька до завершення розробки. Суть технології полягає у тому, що чипи HBM будуть розташовані вертикально над процесорами й поєднані з ними. Це суттєвий крок уперед, порівняно з нинішньою 2,5D-технологією, де HBM чипи та процесори GPU з'єднані горизонтально, через кремнієву підкладку.

Технологія 3D-пакування надає ряд суттєвих переваг для HBM пам'яті, оскільки підвищується швидкість передачі даних, сигнали стають чистішими, знижуються споживання енергії та затримки. Як завжди, єдиним недоліком стає зростання вартості такого продукту. Єдине, що незрозуміло — яку саме пам'ять Samsung збирається зараз встановлювати на мікросхеми. Це вимагає спеціального дизайну чипів, а серед відомих процесорів від великих компаній немає нічого, що підпадає під такі вимоги й може бути випущене до початку 2025 року.
Джерело:
Tom`s Hardware
